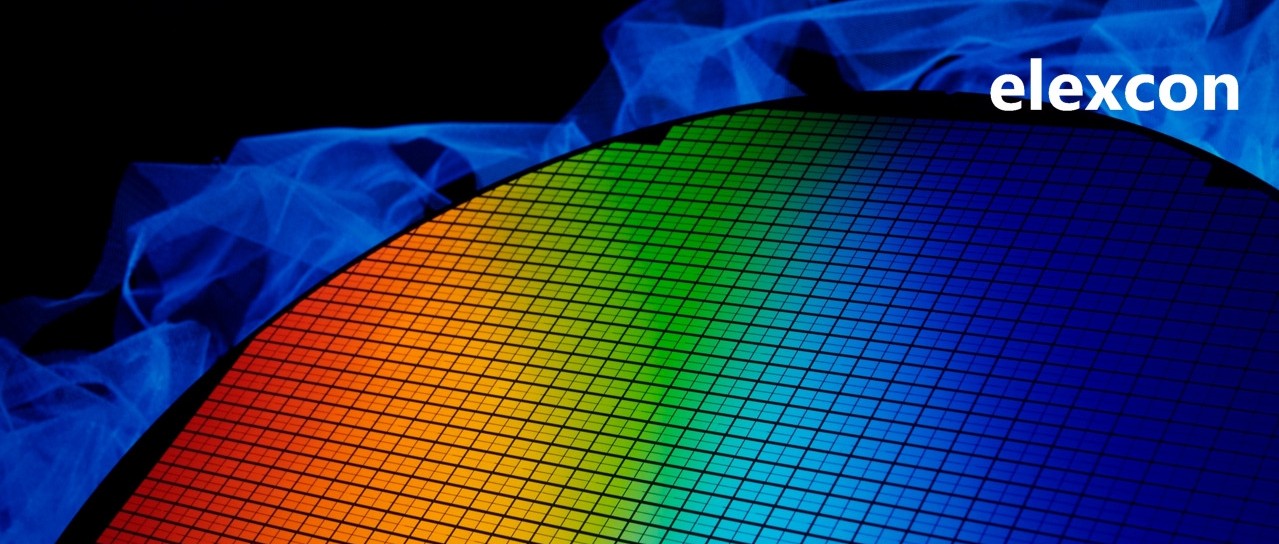
先进封装技术作为“超越摩尔”的关键路径,在提高芯片集成度、缩短芯片距离、加快芯片间电气连接速度以及性能优化的过程中扮演了重要角色。而从传统封装到SiP、2.5D、3D等先进封装,技术迭代需要更多工艺环节,对先进封装材料的需求正在不断增加。
与此同时,人工智能、5G、新能源汽车、物联网、智能制造等新兴产品和应用的不断推陈出新,以及终端设备的智能化、功能多样化、轻薄小型化推动着半导体封装材料朝高导热、高机械强度、高粘结性、低吸水率和低应力方向发展。
今年8月,elexcon半导体展、第八届中国系统级封装⼤会也将汇集全球前沿的IC载板/玻璃基板、先进材料、3D IC设计/EDA工具、Chiplet、先进封装设备、功率半导体装备等实力厂商在深圳会展中心集中亮相!
今天,就让我们一起探索,在先进封装趋势下,材料界的“新星们”是如何在Chiplet大算力芯片、OLED显示屏、功率半导体封装、5G基站、新能源汽车市场发光发热的!
Chiplet重构AI芯片!封装巨头All in TGV玻璃芯基板
随着NVIDIA 、AMD、Intel相继发布高算力Chiplet芯片,AI芯片尺寸/封装基板越来越大。2023年,英特尔正式引爆了玻璃基板概念,将玻璃视为人工智能竞赛中的重要材料,以解决有机基板的翘曲问题。玻璃基板可与ABF载板结合拼接堆叠,通过TGV等技术的支持,能够强化 GPU 的结构并实现更好的电气和机械可靠性,可实现超大尺寸、高组装产量的外形封装,打造越来越庞大、强大的AI芯片,并有望取代或与ABG/BT基板并驾齐驱。
目前,玻璃芯载板已经问世。尽管TGV应用市场尚未大规模启用,但许多半导体厂商已开始积极参与构建相关生态系统。这些举措都为TGV技术的应用及未来发展奠定了基础:
图 1:英特尔组装和测试技术开发工厂的玻璃基板测试装置。资料来源:英特尔
英特尔研发的可共同封装光学元件技术(CPO)利用玻璃基板设计,通过光学传输方式增强信号传输。康宁公司正在积极探索400G及以上的集成光学解决方案,集成电光玻璃基板将被应用于CPO工艺中。在玻璃面板级封装方面,佛智芯和奕成科技是国内首批量产的厂家。在LED方面,玻璃基材料与TGV技术相结合,通格微公司与雷曼光电联合发布了全球首款玻璃基TGV MicroLED显示屏,国内光电显示企业正加速玻璃基产品的商用进程,目前已开始小批量出货。在5G射频领域,厦门云天半导体已实现高性能滤波器晶圆级三维封装的量产,突破了2.5D高密度玻璃中介层技术。在MEMS领域,TGV技术多年前就已被引入设计制造环节,国际大厂纷纷推出玻璃基产品。
图2:封装面积为2700mm2的TGV转接板。来源:云天半导体
此外,英特尔的玻璃研发线将于2027/2028年开始使用玻璃基板,2030年开始批量生产。三星电机宣布开发半导体封装玻璃基板,并计划于2025年生产样品,随后在2026年至2027年正式开始量产。群创光电也投入20亿元新台币,于2024年下半年推出FOPLP玻璃基板,月产能可达1.5万片,并计划在2025年开始二期扩产。应用材料旗下的SKC子公司Absolics也投资6亿美元建设一家月产能达4000块的玻璃基板工厂,计划于2024年下半年开始量产,并在2027-2028年建造第二座工厂,产能达24000片/月。
同时,DNP提出了在2027年大规模量产TGV玻璃芯基板的目标,而LG Innotek也表示了开发玻璃基板用于先进封装的意向。肖特、康宁等公司也已具有规模化量产的玻璃晶圆和面板,为全球产能贡献了上百万片。
上图:CPO封装,来源:康宁。下图:三星电机的玻璃基板
预计未来三年内,这些先行战略性布局的玻璃基板将被应用于英特尔、英伟达、三星或AMD的AI芯片(GPU、CPU、逻辑存储)、硅光集成封装产品、5.5/6G通信产品、华为的纯国产芯片、智能汽车厂商的PMIC/ADAS/RF/RADAR/Logic、马斯克的星链项目,甚至中国更高速的高铁系统等领域。
而这些创新技术及全新产品将在elexcon半导体展上集中亮相。2024年8月27-29日,欢迎相聚深圳会展中心(福田),一探全球玻璃基板产业链及TGV技术,包括奕成科技、佛智芯、云天半导体、通格微、新创元、森丸电子、道铭微、上海微、矩阵科技、德龙激光、志圣科技、均华精密等TGV产业链相关企业都曾在elexcon半导体展上亮相,敬请期待!
苹果新iPad或回归OLED屏,薄膜封装材料将大放异彩!
近日有媒体爆料,苹果iPad Pro 2024将使用混合型OLED(Hybrid-OLED)技术。这种技术是在刚性的玻璃衬底上制作显示器件后,再使用薄膜封装(TFE)对其进行保护的显示技术,不仅可以降低成本,还能降低屏幕的厚度。随着苹果的加入,UBI Research 预测,今年平板电脑 OLED 市场(1200 万片)将比 2023 年(180 万片)增长 567%!
图5:iPad Pro。来源:苹果官网
OLED作为主要的显示技术,封装是其制备过程中一个重要的组成部分。OLED因使用柔性衬底而对环境中的水氧更加敏感,这对封装技术提出了更高的要求。TFE 是在 OLED 表面制备一层或者多层超薄的薄膜材料,以阻隔水氧侵蚀的封装技术。为了实现更低的弯折半径,TFE减薄是一个重要的发展方向,原子层沉积(ALD)是已被广泛研究的可替代PECVD的阻隔膜沉积技术之一。
薄膜封装材料的供应商相对较多,包括三星子公司SDI、日本东丽、韩国LG等,其中三星SDI已逐渐停止提供油墨材料,国内供应商包括奥来德、鼎龙、思摩威等。虽然目前OLED TFE封装材料的主要供应商是SDI。但西安思摩威产线已经量产1吨产能,还有3吨产能在扩,而吉林奥来德则有50吨的产线正在建设。除此以外鼎龙科技则在湖北仙桃的产线中也有类似的产品规划。
功率器件封装,陶瓷基板和环氧树脂将是关键材料!
近期,小米、华为、比亚迪等纷纷入股先进陶瓷材料企业,以保障自己的上游供应链,提升产品质量和竞争力。陶瓷基板是在高温下将铜箔直接键合到氧化铝(Al2O3)、氮化硅(Si3N4)或氮化铝(AlN)等陶瓷基片表面(单面或双面)形成的特殊工艺板。它可以为封装提供电气绝缘和结构特性,满足电动汽车采用大功率、高功率密度器件进行模块封装的要求。
绝缘基板的导热性是半导体器件散热的关键。其中,氮化硅陶瓷基板的热导率远大于氧化铝,在汽车功率封装中成为了应用的主力。且随着电动汽车超级快充站、智能电网、高压光伏风电等领域的迅速发展,覆铜DBC陶瓷基板已不能满足器件的散热需求。新型陶瓷基板DBA(直接覆铝)应运而生,成为电子行业备受关注的材料之一。
此外,环氧树脂作为一种重要绝缘材料被应用于大功率IGBT模块封装中,对模块的绝缘性和可靠性具有重要影响。汽车行业是环氧树脂的主要下游应用之一,据不完全统计,2020年中国汽车行业(涂料、胶及复材)消耗环氧树脂高达18.8万吨。在助力汽车芯片国产化的道路上,环氧树脂行业也大有可为。
5G基站、新能源汽车市场,推动高频高速、大功率电路用铜箔
随着电子信息产业的发展,电子电路铜箔随着 PCB 技术发展而得到广泛应用。在对 CCL 及 PCB 提出更低成本、更高质量要求的同时,也对电子电路铜箔的低成本、高性能、高品质及高可靠性等方面不断提出更严格的要求,如当前 5G基站、数据中心建设将带动高频高速 PCB用铜箔的需求;而充电桩及新能源汽车市场发展,则带动大功率超厚铜箔需求增长。
目前全球电子电路铜箔的主要产区包括中国大陆、中国台湾、日本、韩国等,但是在高端电子电路铜箔方面,生产技术、设备制造技术以及市场份额主要被日本所占据。受全球 PCB 产品需求稳健增长的积极影响,近年来全球电子电路铜箔产量亦处于稳步提升状态。全球电子电路铜箔市场出货量从 2016 年的 34.6 万吨增长至 2022 年的 58 万吨,年均复合增长率达 8.98%。在全球 PCB 产业增长趋势带动下,市场预计至 2025 年电子电路箔出货量仍然会稳定增长。
关于elexcon2024
elexcon2024深圳国际电子展将于2024年8月27-29日在深圳会展中心(福田)举办。汇聚600+家全球优质品牌广商齐聚现场,打造电子全产业链创新展示、一站式采购及技术交流平台。集中展示集成电路、嵌入式系统、电源管理/功率器件、电子元件与供应链、OSAT封装服务、Chiplet异构集成产业链专区、3D IC设计/EDA工具、IC载板/玻璃基板、先进材料、半导体制造专用设备等热门产品;展会期间还将举办一系列技术论坛,展示全球产业动态及未来技术趋势。参展/演讲/赞助请联系:0755-8831 1535,更多展会详情请登录:www.elexcon.com。