深圳国际会展中心(宝安)2026年9月9日-11日
展会倒计时
114 天

先进封装重构系统集成
人工智能与高性能计算的需求,正在不断推动先进封装技术突破摩尔定律的物理桎梏。在这个过程中,最显著的变化是芯片设计的范式正在从单体向异构集成变革。 传统单芯片系统(SoC)因物理极限与成本攀升遭遇瓶颈,而Chiplet技术可以通过将大芯片拆解为模块化芯粒(如CPU、GPU、HBM),并将不同制程节点的计算芯粒与 I/O芯片组合,将多die设计叠加不同的HBM内存等,利用先进封装实现异构集成,从而实现性能与成本的平衡。 这种设计模式可以使IP复用,降低约30%的设计成本,而由于支持逻辑芯片与 I/O芯片的混合制程,因而也显著提升了良率。 然而,异构集成对系统级协同设计构成了挑战。多芯粒集成会带来信号完整性、电源噪声、热应力等物理耦合问题。同时,传统的EDA工具也难以支撑3D堆叠的复杂度,亟需新一代设计工具,包括百亿级互连仿真等能力将成为关键支撑。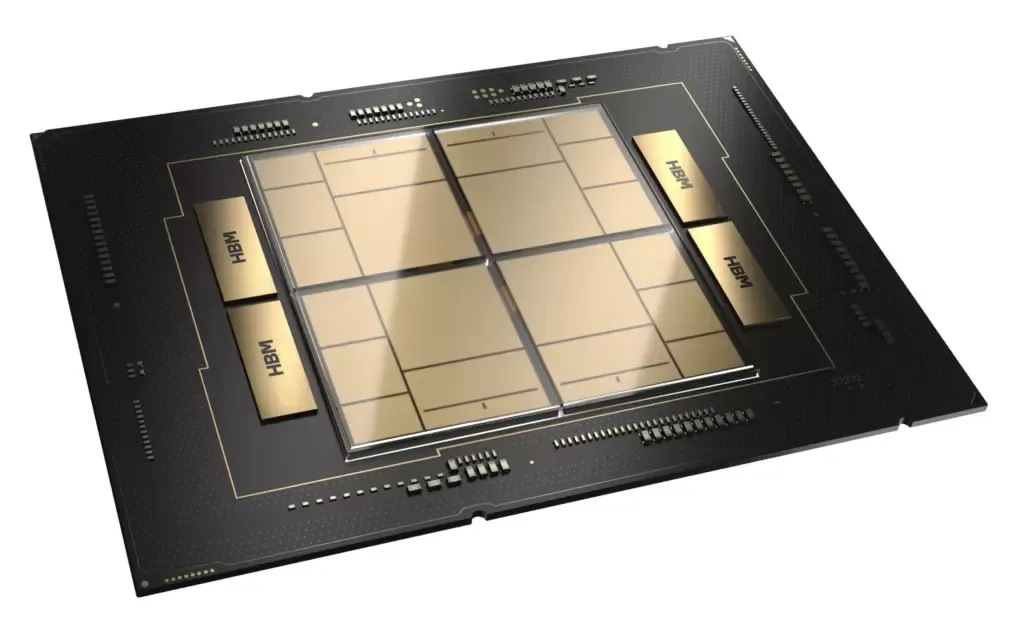
此外,在接口标准化方面,行业也还面临挑战,UCIe(通用芯粒互连)联盟推动开放协议,但实际落地仍存分歧,如英特尔EMIB-T兼容UCIe-A,而台积电CoWoS-L采用私有协议。 从产业生态的角度看,目前,全球先进封装产业的集中度非常高,六大厂商(台积电、英特尔、三星、日月光、安靠、长电科技)以80%的市场份额形成垄断态势,但相关技术路线却分化显著:台积电推出方形面板封装CoPoS,将成本降低20%;英特尔升级EMIB-T技术,通过TSV供电优化支持HBM4集成;三星则构建SAINT 3D堆叠体系,强化垂直整合能力。
虽然技术路线分化,但先进封装的竞争方向的共识一致——从单一技术竞争转向系统级集成能力。短期内,目前的技术满足异构集成的需求;长期来看,光电共封装(如COUPE)、玻璃基板、Chiplet开放生态等,都将重塑产业。 想进一步了解未来先进封装技术路线如何收敛?芯片设计如何革新?材料如何突破?生态如何协同深度融合?2025年8月26-28日,在2025elexcon深圳国际电子展暨嵌入式展,参加同步举行的第九届中国系统级封装大会SiP Conference China2025,了解先进封装的最新动态!
SiP Conference China 2025 第九届中国系统级封装大会
随着AI技术的广泛应用, 尤其是AI大模型训练和推理带来的大算力、高带宽、低功耗需求,不仅推动了存储技术升级和创新,如HBM、CXL等新型存储技术的出现,也为芯片设计、制造技术提供了更多的灵活性和可能性,如异构集成Chiplet、HBM、SiP、CoWoS、FOPLP、玻璃基载板等工艺及技术的兴起。 SiP China2025 将以“智聚芯能,异构互联——AI时代先进封装与Chiplet生态创新”为大会主旨,包含主旨演讲和技术报告,将聚焦AI算力需求爆炸式增长与摩尔定律放缓的矛盾,以先进封装和Chiplet技术为核心,探讨如何通过异构集成、先进封装和高速互连,突破芯片性能瓶颈,推动AI芯片和AI智算系统在能效上的革新。
大会主席团 SiP Conference China 2025




部分展商亮点 广东风华芯电科技股份有限公司 【 展位号:1Y50 】 企业简介 广东风华芯电科技股份有限公司,成立于2000年,是佛山市国星光电(002449)的控股子公司,国家级高新技术企业。公司位于广州科学城,拥有3万平米厂区、4.5万平米厂房及20余条先进封装测试生产线,现有员工400余人,年产能超60亿只分立器件及7亿块集成电路。 公司通过ISO9001、ISO14001、IATF16949、ISO45001等多项管理体系认证及环保认证(RoHS、REACH等)。在集成电路封装领域拥有多项核心专利,是国家首批鼓励的94家集成电路企业之一,获评广东省先进微电子封装测试工程技术研究开发中心、广东省专精特新中小企业等荣誉。 风华芯电提供标准化与定制化服务,产品涵盖TO、SOT、SOD、SOP、QFN、DFN等二十余种封装形式的分立器件及集成电路。在巩固中端封装产品优势的同时,重点发展QFN、DFN、QFP、BGA、CSP、SiP等高端封装技术,并向高附加值、绿色节能的中大功率器件及电源管理IC方向拓展。 产品广泛应用于家电、消费电子、计算机、网络通讯、汽车电子、照明及IC封装测试OEM市场,致力于成为卓越的半导体器件及封装测试服务供应商。


深圳市芯友微电子科技有限公司 【 展位号:1Y26 】 企业简介 深圳市芯友微电子科技有限公司的产品家族兼具丰富品类与硬核优势,以先进封装技术为核心竞争力,覆盖多领域需求。 小信号器件方面,TVS、SBD二极管月产能达300kk以上,凭借体积较传统封装缩小70%以上的优势,广泛应用于智能手机、可穿戴设备,且成本大幅降低。 中高功率器件中,MOSFET、整流桥适配电动工具与工业控制系统,具备散热效率提升30%、信号损耗减少50%的特性,适配SiCGaN等第三代半导体,功率密度最大提升50%以上。 系统级封装(SiP)提供嵌埋芯片模组、多芯合封解决方案,支持多芯片异质集成,服务汽车电子与新能源领域,单机台产能达传统封装数倍,产线投资成本降低60%,生产效率提升数十倍,兼顾高性价比与快速交付,满足通用标准化与高端定制化需求。![]()
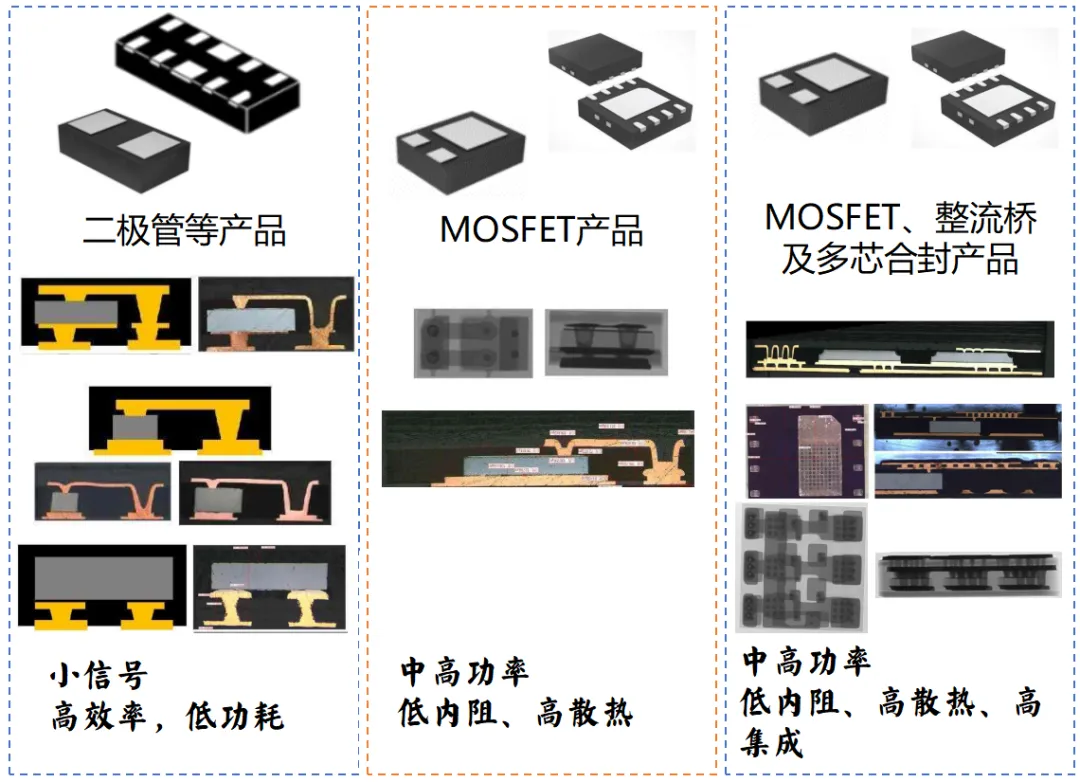
长沙安牧泉智能科技有限公司 【 展位号:1Y30 】 业务介绍 领先的设计仿真能力:核心设计人员在计算芯片(CPU、GPU、ADC等) 领域拥有丰富设计/仿真经验,擅长高功率、大尺寸、高性能封装的电源完整性优化和领先的客户芯片co-design能力。 擅长大芯片先进封装服务:专注于CPU、GPU、ADC和AI等大芯片倒装封装(FC)和系统级封装(SIP)。芯片封装尺寸可达102X102mm², 基板层数超过20层,器件数量>200个,接近国内领先水平。 完备的FA&Rel和供应链配套:拥有完备的可靠性测试与失效分析设备及能力,已具备JEDEC标准成套可靠性测试能⼒,翘曲测试、超声波扫描、磨片、元素分析等能⼒完备。完整的供应链配套,国产载板龙头战略合作伙伴,全球载板龙头首选伙伴。 企业简介 长沙安牧泉智能科技有限公司坐落于湖南湘江新区,专注于倒装-系统级封装(FC-SiP), 致力于 CPU、GPU、ADC、AI、DCDC等芯片的国产化。![]()

湖南越摩先进半导体有限公司 【 展位号:1V39 】 业务介绍 4644芯片最初源于ADI(美国亚德诺半导体)的 LTM4644 型号。该芯片作为高性能DC/DC转换模块,因集成度高(四通道降压设计)、宽电压范围(4~14V输入)、多路输出等特点被广泛采用。国内厂商在进行技术对标时,保留 核心数字“4644”作为通用代号,便于市场识别和产品兼容性设计。 LTM4644主要用于FPGA/ASIC供电、军工雷达、数据中心存储、医疗设备及车载电子等高可靠性领域。其多输出可配置特性(单路16A至四路4A)满足复杂系统的多电压需求。 企业简介 公司提供涵盖先进封装设计、多物理场仿真、一站式SiP先进封装量产等全流程服务。 已量产的产品线包括SiP、fcBGA、LGA/BGA/fcCSP、QFN/DFN以及Chiplet等。 产品广泛应用于高性能计算、存储、汽车电子、射频、物联网、工业控制、电源管理、传感器及消费品电子等众多领域。
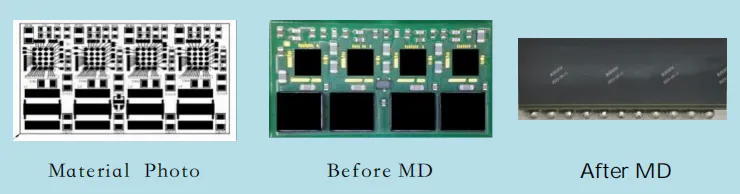
合肥矽迈微电子科技有限公司 【 展位号:1T36 】 业务介绍 双面基板级扇出型封装工艺(FOPLP) 企业简介 合肥矽迈微电子科技有限公司成立于2015年,注册资金5.05亿元,前期投资达6.5亿元。位于合肥市高新区。公司秉承“科技创新,自主研发”原则,致力成为一家半导体先进封装科技企业。 公司以自主专利为基础,于2019年建成国内第一条具备量产能力的基板扇出型封装生产线;已申请150余项相关技术专利;荣获“国家高新技术企业”称号。 通过ISO9001、QC080000、IATF16949等体系认证。 封装类型包括新型CSP、DFN、QFN、SIP及BGA等。产品涵盖TVS、MOS、电源管理类IC、系统级3D模块、RFID电子标签和RF射频类等。产品具有结构灵活、封装尺寸小、集成度高、高导电性、高散热性、高可靠性及寄生参数低等特点;应用于消费类电子、工业设备、物联网、通讯、汽车电子等多个领域。![]()
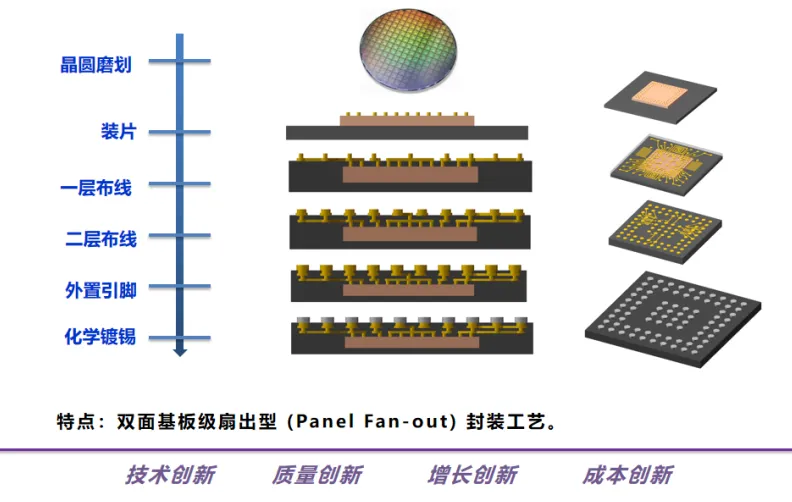
智聚芯能,专业观众注册开启
中国系统级封装大会作为中国最重要的SiP会议,在全球SiP与先进封测领域享有广泛影响力,于2017至2024年期间共吸引了来自中国、美国、法国、德国、意大利、荷兰、日本、韩国、印度、新加坡、马来西亚等国际及地区的250+家企业参与,每年线下汇聚600-2000+位专业观众,实现了前沿技术交流,高端圈层的融合。 诚邀 OSAT、晶圆厂、EMS厂、IC设计、电子、汽车、半导体等企业,覆盖企业生产制造/工艺、工程技术、采购及研发/设计等专业人士注册参会,共探先进封装技术如何重塑AI智算系统生态。
长按识别二维码 立即注册锁定席位 ? 与行业领袖共绘未来芯片架构蓝图! elexcon 展位预定:https://m-v2.huicanzhan.cn/a/619943016797189
参观门票领取:https://reg.elexcon.com/ex-cn/index.html?ly=GZHYDJ-ZW
elexcon2025 联系我们 展位预定/赞助申请,请联系: 电话:0755-88311535 邮箱:elexcon.sales@cetimes.com 参观/组团,请联系: 电话:0755-88312779 邮箱:Nora.Xie@cetimes.com